工研院「高深寬比玻璃基板電鍍填孔及檢測技術」助半導體產業封裝升級
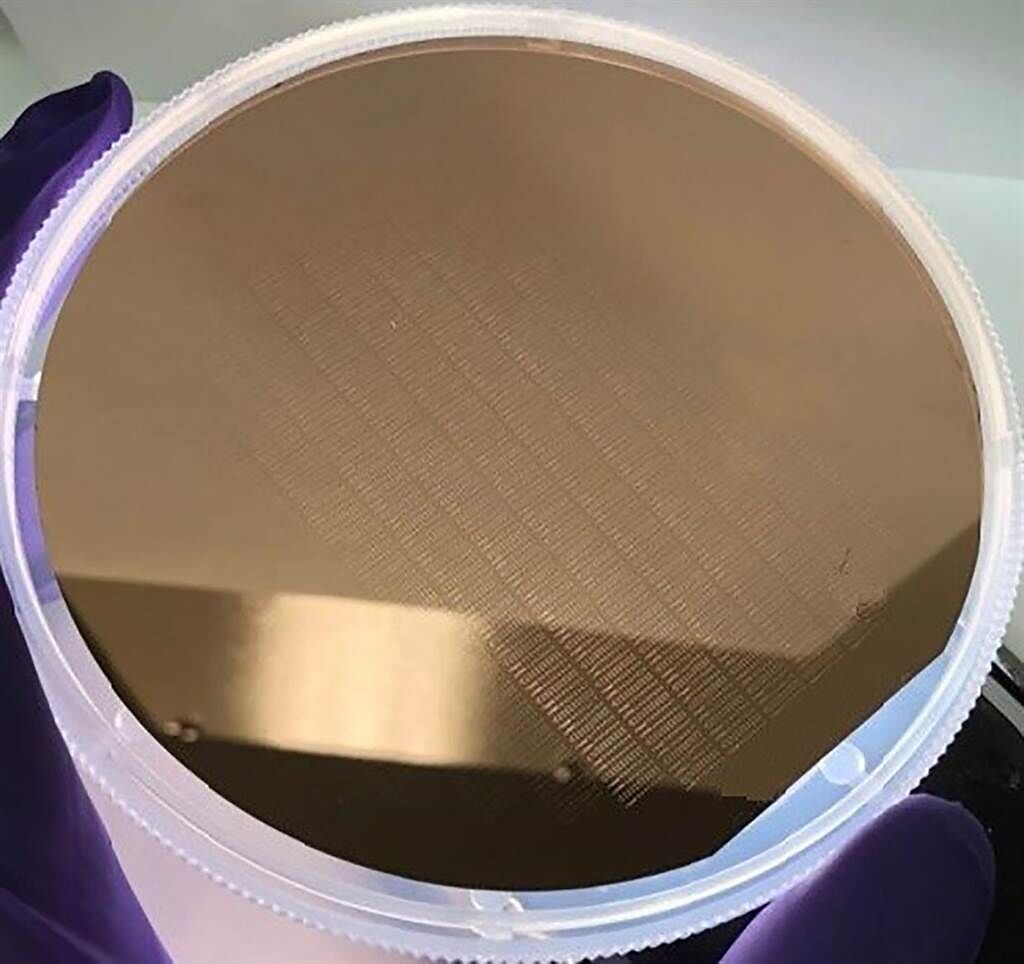
半導體與電路板是台灣經濟成長的二個重要命脈,工研院研發「高深寬比玻璃基板電鍍填孔及檢測技術」,能確保電訊與電力的傳輸品質,讓半導體先進封裝技術,由矽晶圓級封裝升級為玻璃面板級封裝,協助半導體與電路板產業快速切入下世代生產製造。
工研院機械所副組長黃萌祺指出,玻璃中介層先進封裝技術,可透過3D堆疊技術整合晶片與印刷電路板,取代現有的IC載板,一直是全球大廠關注的平台技術。
隨著半導體先進製程不斷演進,使鑲嵌在中介層中立體導線的深寬比不斷增加,深寬比愈高也代表製程愈難,因此半導體產業封裝能否升級,關鍵就在研發出可確保電訊和電力傳輸無礙的高深寬比電鍍填孔技術。
工研院以全濕式製程研發的「高深寬比玻璃基板電鍍填孔及檢測技術」,具有高深寬比、高品質及低成本的「二高一低」特色。
高深寬比達15是全球最佳,領先產學界的4到10,採用玻璃基板電鍍填孔,能有效降低電鍍製程缺陷,達到無缺陷填孔的目標,確保產品高品質,也解決目前先進封裝堆疊整合問題。
更重要的是,採用全濕式製程可提升7成階梯覆蓋率,使成本降低5成,搭配超高解析3D X光檢測技術,能精準確保產品的良率。
黃萌祺形容這項技術就像蓋大樓,玻璃基板有如樓地板,必須將樓板鑽孔打通,串接上下層管線,大樓才能順暢運作,大樓蓋得再高,也能保證電訊與電力的傳輸品質,協助業界解決痛點。
該技術今年獲得工研菁英傑出研究金牌獎,目前已與國際玻璃大廠合作,協助半導體先進封裝技術,由矽晶圓級封裝升級為玻璃面板級封裝,切入國際半導體封裝、顯示器與PCB供應鏈,協助台灣產業與國際市場無縫接軌。
(本文由 中國時報 提供)










